01
การแนะนำ
การตัดแผ่นเวเฟอร์เป็นส่วนสำคัญของการผลิตอุปกรณ์เซมิคอนดักเตอร์ วิธีการหั่นและคุณภาพส่งผลโดยตรงต่อความหนา ความหยาบ ขนาด และต้นทุนการผลิตของแผ่นเวเฟอร์ และมีผลกระทบอย่างมากต่อการผลิตอุปกรณ์ ซิลิคอนคาร์ไบด์ในฐานะวัสดุเซมิคอนดักเตอร์ยุคที่สาม-เป็นวัสดุสำคัญที่ขับเคลื่อนการปฏิวัติทางไฟฟ้า ต้นทุนการผลิตซิลิคอนคาร์ไบด์ผลึกคุณภาพสูง-นั้นสูงมาก และโดยทั่วไปผู้คนหวังที่จะตัดก้อนซิลิคอนคาร์ไบด์ขนาดใหญ่ให้เป็นซับสเตรตเวเฟอร์ซิลิคอนคาร์ไบด์บางๆ ให้ได้มากที่สุด ในขณะเดียวกัน การเติบโตของอุตสาหกรรมได้นำไปสู่ขนาดเวเฟอร์ที่ใหญ่ขึ้นเรื่อยๆ ซึ่งทำให้ข้อกำหนดสำหรับกระบวนการหั่นลูกเต๋าเพิ่มมากขึ้น อย่างไรก็ตาม ซิลิคอนคาร์ไบด์นั้นมีความแข็งมาก โดยมีความแข็ง Mohs อยู่ที่ 9.5 รองจากเพชร (10) เท่านั้น และยังมีความเปราะอีกด้วย ทำให้ตัดได้ยาก ปัจจุบันวิธีการทางอุตสาหกรรมโดยทั่วไปจะใช้การเลื่อยลวดแบบสารละลายหรือเลื่อยลวดเพชร ในระหว่างการตัด เลื่อยลวดคงที่ที่มีระยะห่างเท่ากันจะถูกวางรอบๆ แท่งซิลิคอนคาร์ไบด์ และแท่งโลหะจะถูกตัดโดยใช้เลื่อยลวดยืด เมื่อใช้วิธีเลื่อยลวด การแยกแผ่นเวเฟอร์ออกจากแท่งโลหะขนาดเส้นผ่านศูนย์กลาง 6 นิ้วจะใช้เวลาประมาณ 100 ชั่วโมง เวเฟอร์ที่ได้จะมีรอยตัดที่กว้าง พื้นผิวที่หยาบกว่า และการสูญเสียวัสดุสูงถึง 46% สิ่งนี้จะเพิ่มต้นทุนในการใช้วัสดุซิลิกอนคาร์ไบด์ และจำกัดการพัฒนาในอุตสาหกรรมเซมิคอนดักเตอร์ โดยเน้นถึงความจำเป็นเร่งด่วนในการวิจัยเกี่ยวกับเทคโนโลยีการตัดเวเฟอร์เวเฟอร์ซิลิคอนคาร์ไบด์ใหม่
ในช่วงไม่กี่ปีที่ผ่านมา การใช้เทคโนโลยีการตัดด้วยเลเซอร์ได้รับความนิยมมากขึ้นในการผลิตวัสดุเซมิคอนดักเตอร์ วิธีนี้ทำงานโดยใช้ลำแสงเลเซอร์แบบโฟกัสเพื่อปรับเปลี่ยนพื้นผิวของวัสดุหรือภายใน และแยกออกจากกัน เนื่องจากเป็นกระบวนการที่ไม่ต้องสัมผัส- จึงหลีกเลี่ยงการสึกหรอของเครื่องมือและความเค้นทางกล ดังนั้นจึงปรับปรุงความหยาบและความแม่นยำของพื้นผิวเวเฟอร์ได้อย่างมาก ขจัดความจำเป็นในกระบวนการขัดเงาที่ตามมา ลดการสูญเสียวัสดุ ลดต้นทุน และลดมลภาวะต่อสิ่งแวดล้อมที่เกิดจากการบดและขัดแบบดั้งเดิม เทคโนโลยีการตัดด้วยเลเซอร์ถูกนำมาใช้กับการหั่นแท่งซิลิคอนมานานแล้ว แต่การใช้งานในสนามซิลิคอนคาร์ไบด์ยังไม่สมบูรณ์ ปัจจุบันมีเทคนิคหลักหลายประการ
02
น้ำ-การตัดด้วยเลเซอร์แบบมีไกด์
เทคโนโลยีเลเซอร์นำวิถีน้ำ- (Laser MicroJet, LMJ) หรือที่เรียกว่าเทคโนโลยีเลเซอร์ไมโครเจ็ท- ทำงานบนหลักการของการเน้นลำแสงเลเซอร์ไปที่หัวฉีดขณะที่มันไหลผ่านห้องเก็บน้ำที่ปรับแรงดัน- สายฉีดน้ำแรงดันต่ำ-ถูกขับออกจากหัวฉีด และเนื่องจากดัชนีการหักเหของแสงที่ส่วนต่อประสานอากาศของน้ำ-แตกต่างกัน จึงเกิดท่อนำคลื่นแสงขึ้น ซึ่งช่วยให้เลเซอร์แพร่กระจายไปตามทิศทางของการไหลของน้ำ วิธีนี้จะแนะนำ-เครื่องฉีดน้ำแรงดันสูงในการประมวลผลและตัดพื้นผิวของวัสดุ ข้อได้เปรียบหลักของการตัดด้วยเลเซอร์ด้วยน้ำ-อยู่ที่คุณภาพการตัด การไหลของน้ำไม่เพียงแต่ทำให้พื้นที่ตัดเย็นลง ลดการเปลี่ยนรูปเนื่องจากความร้อนและความเสียหายจากความร้อนต่อวัสดุ แต่ยังช่วยขจัดเศษในกระบวนการแปรรูปอีกด้วย เมื่อเทียบกับการตัดลวดเลื่อยแล้วจะเร็วกว่ามาก อย่างไรก็ตาม เนื่องจากน้ำดูดซับความยาวคลื่นเลเซอร์ที่แตกต่างกันไปในองศาที่แตกต่างกัน ความยาวคลื่นเลเซอร์จึงถูกจำกัด โดยหลักอยู่ที่ 1,064 นาโนเมตร, 532 นาโนเมตร และ 355 นาโนเมตร
ในปี 1993 นักวิทยาศาสตร์ชาวสวิส Beruold Richerzhagen ได้เสนอเทคโนโลยีนี้เป็นครั้งแรก เขาก่อตั้ง Synova บริษัทที่อุทิศตนเพื่อการวิจัย การพัฒนา และการจำหน่ายเทคโนโลยีเลเซอร์นำวิถีน้ำ- ซึ่งอยู่ในระดับแนวหน้าระดับนานาชาติ เทคโนโลยีในประเทศค่อนข้างล้าหลัง แต่บริษัทต่างๆ เช่น Innolight และ Shengguang Silicon Research กำลังพัฒนาเทคโนโลยีดังกล่าวอย่างแข็งขัน
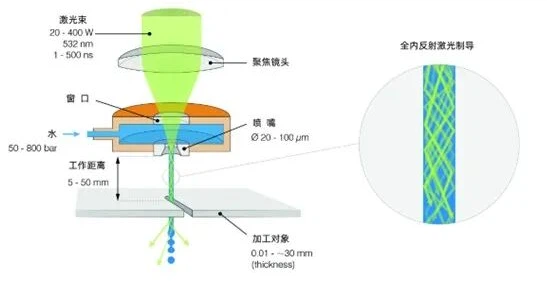
03
ลูกเต๋าชิงทรัพย์
Stealth Dicing (SD) เป็นเทคนิคที่เลเซอร์ถูกโฟกัสภายในเวเฟอร์ซิลิคอนคาร์ไบด์ผ่านพื้นผิวเพื่อสร้างชั้นที่ได้รับการดัดแปลงที่ความลึกที่ต้องการ ทำให้สามารถแยกเวเฟอร์ได้ เนื่องจากไม่มีการตัดบนพื้นผิวเวเฟอร์ จึงสามารถบรรลุความแม่นยำในการประมวลผลที่สูงขึ้นได้ กระบวนการ SD ที่มีเลเซอร์พัลส์นาโนวินาทีได้ถูกนำมาใช้ในอุตสาหกรรมเพื่อแยกเวเฟอร์ซิลิคอน อย่างไรก็ตาม ในระหว่างการประมวลผล SD ของซิลิคอนคาร์ไบด์ที่เกิดจากเลเซอร์พัลส์นาโนวินาที ระยะเวลาพัลส์จะนานกว่าเวลาเชื่อมต่อระหว่างอิเล็กตรอนและโฟนันในซิลิคอนคาร์ไบด์ (ในระดับพิโควินาที) มาก ซึ่งส่งผลให้เกิดผลกระทบทางความร้อน การป้อนความร้อนสูงบนแผ่นเวเฟอร์ไม่เพียงทำให้การแยกตัวมีแนวโน้มที่จะเบี่ยงเบนไปจากทิศทางที่ต้องการเท่านั้น แต่ยังสร้างความเค้นตกค้างที่สำคัญ ซึ่งนำไปสู่การแตกหักและความแตกแยกที่ไม่ดี ดังนั้น เมื่อประมวลผลซิลิคอนคาร์ไบด์ โดยทั่วไปกระบวนการ SD จะใช้เลเซอร์พัลส์ที่สั้นเกินขีด ซึ่งช่วยลดผลกระทบด้านความร้อนได้อย่างมาก
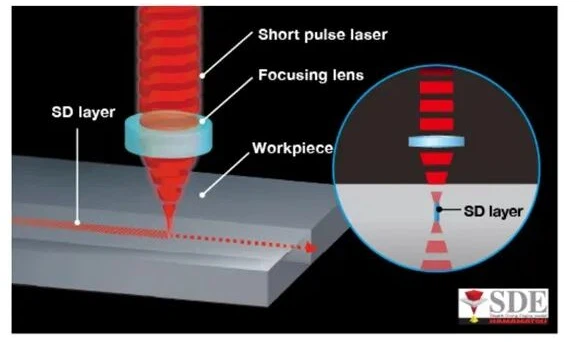
บริษัทญี่ปุ่น DISCO ได้พัฒนาเทคโนโลยีการตัดด้วยเลเซอร์ที่เรียกว่า Key Amorphous-Black Repetitive Absorption (KABRA) ตัวอย่างเช่น ในการประมวลผลแท่งซิลิคอนคาร์ไบด์หนา 20 มม. ที่มีเส้นผ่านศูนย์กลาง 6- นิ้ว จะช่วยเพิ่มประสิทธิภาพการทำงานของเวเฟอร์ซิลิคอนคาร์ไบด์ถึงสี่เท่า กระบวนการ KABRA เน้นเลเซอร์ภายในวัสดุซิลิกอนคาร์ไบด์เป็นหลัก ซิลิคอนคาร์ไบด์จะถูกสลายตัวเป็นซิลิคอนอสัณฐานและคาร์บอนอสัณฐานผ่าน 'การดูดซึมซ้ำแบบอสัณฐาน-ดำ' ก่อตัวเป็นชั้นที่ทำหน้าที่เป็นจุดแยกเวเฟอร์ หรือที่เรียกว่าชั้นอสัณฐานสีดำ ซึ่งดูดซับแสงได้มากขึ้น ทำให้แยกเวเฟอร์ได้ง่ายขึ้นมาก

เทคโนโลยีเวเฟอร์ Cold Split ที่พัฒนาโดย Siltectra ซึ่ง Infineon เข้าซื้อกิจการ ไม่เพียงแต่สามารถแบ่งแท่งโลหะประเภทต่างๆ ให้เป็นเวเฟอร์ได้ แต่ยังช่วยลดการสูญเสียวัสดุได้สูงสุดถึง 90% โดยแต่ละเวเฟอร์สูญเสียเพียง 80µm ซึ่งท้ายที่สุดแล้วจะช่วยลดต้นทุนการผลิตอุปกรณ์ทั้งหมดได้สูงสุดถึง 30% เทคโนโลยี Cold Split เกี่ยวข้องกับสองขั้นตอน: ขั้นแรก เลเซอร์จะฉายรังสีแท่งโลหะเพื่อสร้างชั้นการแยกชั้น ทำให้เกิดการขยายตัวของปริมาตรภายในในวัสดุซิลิกอนคาร์ไบด์ ซึ่งทำให้เกิดความเค้นดึงและก่อให้เกิดรอยแตกขนาดจิ๋ว-ที่แคบมาก จากนั้น ขั้นตอนการทำความเย็นด้วยโพลีเมอร์จะเปลี่ยนรอยแตกขนาดเล็ก-ให้เป็นรอยแตกหลัก และในที่สุดจะแยกแผ่นเวเฟอร์ออกจากแท่งโลหะที่เหลือ ในปี 2019 บุคคลที่สามได้ประเมินเทคโนโลยีนี้และวัดความหยาบผิว Ra ของเวเฟอร์แบบแยกให้มีค่าน้อยกว่า 3µm โดยผลลัพธ์ที่ดีที่สุดจะน้อยกว่า 2µm

เลเซอร์หั่นสี่เหลี่ยมลูกเต๋าที่ได้รับการดัดแปลงซึ่งพัฒนาโดยบริษัท Han's Laser ของจีน เป็นเทคโนโลยีเลเซอร์ที่ใช้ในการแยกเวเฟอร์เซมิคอนดักเตอร์ออกเป็นชิปหรือดายแต่ละตัว กระบวนการนี้ยังใช้ลำแสงเลเซอร์ที่แม่นยำในการสแกนและสร้างชั้นที่ปรับเปลี่ยนภายในเวเฟอร์ ช่วยให้เวเฟอร์แตกตามเส้นทางการสแกนด้วยเลเซอร์ภายใต้ความเครียดที่ใช้ ทำให้ได้การแยกที่แม่นยำ
รูปที่ 5 ขั้นตอนกระบวนการหั่นเลเซอร์แบบดัดแปลง
ในปัจจุบัน ผู้ผลิตในประเทศเชี่ยวชาญด้านเทคโนโลยีการหั่นซิลิกอนคาร์ไบด์ที่ใช้สารละลาย- อย่างไรก็ตาม การตัดแบบสารละลายมีการสูญเสียวัสดุสูง ประสิทธิภาพต่ำ และมลภาวะที่รุนแรง และค่อยๆ ถูกแทนที่ด้วยเทคโนโลยีการตัดแบบลวดเพชร ในเวลาเดียวกัน Laser dicing มีความโดดเด่นเนื่องจากประสิทธิภาพและข้อได้เปรียบด้านประสิทธิภาพ เมื่อเปรียบเทียบกับเทคโนโลยีการประมวลผลการสัมผัสทางกลแบบดั้งเดิม ให้ประโยชน์มากมาย รวมถึงประสิทธิภาพในการประมวลผลสูง เส้นอาลักษณ์แคบ และความหนาแน่นของรอยตัดสูง ทำให้เป็นคู่แข่งที่แข็งแกร่งในการเปลี่ยนการหั่นลวดเพชร โดยเปิดเส้นทางใหม่สำหรับการประยุกต์ใช้วัสดุเซมิคอนดักเตอร์รุ่นต่อไป- เช่น ซิลิคอนคาร์ไบด์ ด้วยความก้าวหน้าของเทคโนโลยีอุตสาหกรรมและการเพิ่มขึ้นอย่างต่อเนื่องของขนาดซับสเตรตของซิลิกอนคาร์ไบด์ เทคโนโลยีการหั่นซิลิกอนคาร์ไบด์จะพัฒนาอย่างรวดเร็ว และมีประสิทธิภาพ-การหั่นด้วยเลเซอร์คุณภาพสูง-จะเป็นแนวโน้มสำคัญสำหรับการตัดซิลิคอนคาร์ไบด์ในอนาคต









